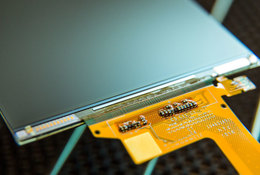
COF Tape供應吃緊,引發TDDI技術路徑之爭

2017Q4以來,電子零組件廠商面臨三大利空夾殺:
1. Phone 8/8+、iPhone X出貨量大幅下修,尤其iPhone X肩負新世代手機的樣板,卻叫好不叫座,表現令人失望。
2. 中國手機品牌廠持續調整庫存,四大品牌2018Q1零組件訂單驟降,二線品牌樂視、金立也相繼傳出財務危機。
3. 新台幣匯率持續強勢,對外銷產業營收、毛利率造成衝擊。
因此,過去這段期間,不論光學鏡頭、機殼、PCB、觸控模組、EMS組裝、聲學元件……等零組件供應商,股價表現皆非常弱勢。
本文為「定錨產業週報(基本版) 2018/4/14號」的內容節錄及補充資料,若對相關供應鏈的營運概況有興趣,歡迎以每日3元的價格訂閱「定錨產業週報(基本版)」,獲得更詳細的資訊。
但近期定錨研究團隊積極走訪產業,看到了不少轉機:
1. 中國手機品牌廠庫存調整已近尾聲,四大品牌相繼發表樂觀的展望,且觀察IC設計端2018年3月營收表現,以及大立光法說會釋出的2018Q2展望,皆支持中國手機品牌拉貨動能回溫的看法。
2. iPad、MacBook Air即將上市,我們曾在「定錨產業週報2018/3/31號」分析過,Apple今年改走平價策略,有助衝刺銷售量。
3. 受到被動元件嚴重缺料問題影響,今年iPhone備貨時程將提前至2018年5月,零組件廠商將在2018Q2季末開始出貨。
當然,次產業的表現可能會有所差異,定錨研究團隊整理如下:
3D感測
Apple今年將推出三款iPhone,包括6.1” TFT-LCD、5.8” OLED、6.5” OLED,市場預期三款iPhone都會支援Face ID。
未來須留意Finisar、II-VI 6吋產能逐漸完備後,是否會影響穩懋在iPhone VCSEL供貨比重,以及全新是否有機會打破IQE獨家供應VCSEL磊晶片的局面,另宏捷科在Android品牌導入3D感測的過程中,也很可能扮演關鍵角色。
光學鏡頭
目前市場預期,OLED版本將搭載雙鏡頭,TFT-LCD版本則維持單鏡頭規格。
由於OLED版本受限螢幕模組成本居高不下,難以調降定價,但消費者對於高價iPhone的接受度似乎有限,故Apple有可能會調降TFT-LCD版本定價至700美元附近,衝刺銷售量。市場預期,今年iPhone備貨量約1億支,其中TFT-LCD版本佔60%,此趨勢不利雙鏡頭滲透率提升。
然而,中國手機品牌領導廠商華為,在今年旗艦機P20推出後置三鏡頭模組,對於光學鏡頭產業來說是一大利多,且市場必然會開始期待Apple在2019年跟進導入三鏡頭規格。
機殼
今年iPhone將持續採用玻璃機殼,不同的是,預期鎧勝-KY將首度切入iPhone機殼供應鏈,供貨比重約5~10%。
由於鴻海iPhone組裝代工訂單持續遭和碩及緯創分食,且OLED版本銷售佔比下滑,不利鴻海接單,預期鴻準的機殼訂單分配將會下滑,並由可成、鎧勝-KY取代,而Jabil的訂單分配則會維持相對穩定。
PCB
我們將iPhone採用的PCB分為三大類來觀察:
類載板(SLP):今年SLP規格差異不大,維持TFT-LCD版10層、OLED版20層結構,未來將持續朝尺寸縮小、線寬更細、層數更多發展。由於廠商經過一年的努力,良率已普遍提升,今年合格供應商將從5家增加至7家,競爭趨於激烈,價格將面臨壓力。
軟硬結合板(Rigid-Flex PCB):儘管電池模組Rigid-Flex PCB面積將會增加20~30%,但螢幕模組因去年供應商屢傳良率問題,將從Rigid-Flex PCB改回FPCB,整體需求成長不如預期,加上近年廠商對於Rigid-Flex PCB產能擴充相對積極,競爭趨於激烈。
軟板(FPCB):除了Cellular天線將採用LCP材質,由日商Murata與嘉聯益供貨,其餘天線仍維持改良式PI材質,供應商包括台郡、臻鼎-KY,無線充電FPCB則因Apple有意用銅絲繞線設計取代FPCB模組,有可能導致現有供應商訂單流失。
觸控模組
雖然TFT-LCD版放棄in-cell面板,重回外掛式觸控,觸控模組廠商可望再度接到貼合訂單,但據傳在成本考量下,TFT-LCD版將取消3D壓力感測器,對於毛利率會有不少影響。
另一方面,近期市場傳言Samsung正在說服Apple改採Y-Octa OLED,因不再需要觸控薄膜,不僅更為輕薄,價格也較便宜,惟Apple在供應鏈管理策略考量下尚未點頭。
雖然過去OLED觸控薄膜,都是由Samsung指定供應商,在OLED產線上進行一條龍貼合,但台廠還是有分食到3D壓力感測器貼合訂單,如果Apple決定採用Y-Octa OLED,恐將移除3D壓力感測功能,對台廠將產生不利影響。
EMS組裝
目前市場預期,鴻海為OLED版本主要供應商,和碩為TFT-LCD版本主要供應商。緯創在2018年3月,傳出防水機構件偷換料事件,有可能會影響到未來接單,須持續觀察。
由於EMS組裝廠商營收,通常會落後零組件廠商2~3個月,而今年消費性電子產業訂單能見度不高,建議先觀察零組件廠商拉貨動能。